Eine neue Zuverlässigkeitstestmethode, die sowohl den Transistor als auch die Diode belastet, wird angewendet, um repräsentative Zuverlässigkeitsdaten für E-Mobility-Anwendungen zu erhalten. Ein direkter Vergleich zwischen einer Zwei-Chip-Technologie (IGBT/Diode) und einer Ein-Chip-Technologie (SiC MOSFET) mit demselben Gehäuse und unter identischen Testbedingungen, ist möglich.

Hintergrund
Der Antriebsstrang eines Elektrofahrzeugs arbeitet als Wechselrichter, wenn der Motor aus der Batterie gespeist wird (Beschleunigung), und als Gleichrichter, wenn er in die Batterie zurückspeist (rekuperierendes Bremsen). Wenn z. B. ein typischer 3-phasiger aktiver Gleichrichter/Wechselrichter im Wechselrichterbetrieb arbeitet, arbeiten die Transistoren aufgrund eines höheren Transistorstroms bei höheren Temperaturen als die Dioden. Im Gleichrichterbetrieb führen die Dioden mehr Strom als die Transistoren und erfahren somit eine höhere thermische Belastung. Ein-Chip- (MOSFETs) und Zwei-Chip-Technologien (IGBT/Diode) führen zu unterschiedlichen Lastprofilen und unterschiedlichen Sperrschichttemperaturschwankungen, die eine wichtige Rolle für die Zuverlässigkeit der Bauteile und somit des Systems spielen.
Ziele
- Elektrische Simulation der E-Mobilitäts-Anwendung mit realistischen Einsatzprofilen: Ein-Chip- vs. Zwei-Chip-Technologie
- Validierung des bidirektionalen Power-Cycling-Prüfstandes
- Bidirektionales Power-Cycling von Si IGBTs/Dioden und SiC MOSFETs durch Belastung von Transistor und Diode
- Zuverlässigkeitsbewertung von SiC MOSFETs und Si IGBTs für E-Mobility-Anwendungen
Resultate
Es wird eine Zuverlässigkeitsstudie von Leistungshalbleiter-Bauelementen in einer Elektrofahrzeug-Anwendung durchgeführt, basierend auf einem Fahrzyklus-Missionsprofil. Ein Fahrzyklus mit der Geschwindigkeit des Fahrzeugs (km/h) als Funktion der Zeit wird in das Drehmoment und die Drehzahl der Motorwelle umgewandelt, was als Eingangs-Profil für die elektrische Simulation dient. Diese enthält die elektrothermischen Modelle und Datenblattparameter der Leistungshalbleiter. Als Ergebnis wird die thermische Belastung des Transistors/der Diode für die beiden Topologien (IGBT/Diode uns MOSFET) berechnet. Das thermische Verhalten für das gegebene Einsatzprofil ist in Abb. 3. dargestellt. Folgendes ist zu beobachten:
- Zwei-Chip-Konfigurationen (Si IGBT/Diode) haben zwei überlagerte thermische Beanspruchungen: Schwankungen aus (i) der Motorfrequenz und (ii) dem Fahrprofil.
- Ein-Chip-Konfigurationen (SiC MOSFET) haben nur die aus dem Einsatzprofil resultierende thermische Belastung.
- In diesem Fall ist der SiC-MOSFET thermisch weniger stark thermisch belastet als der Si IGBT.
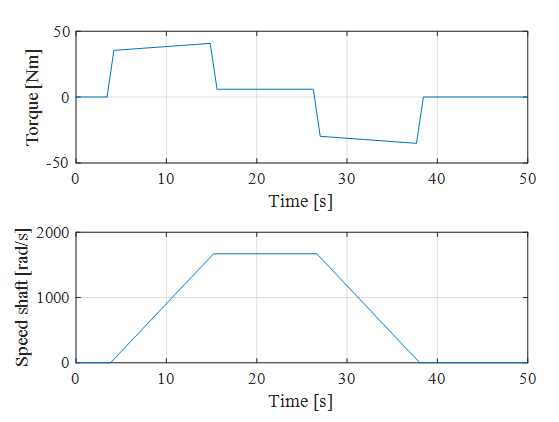
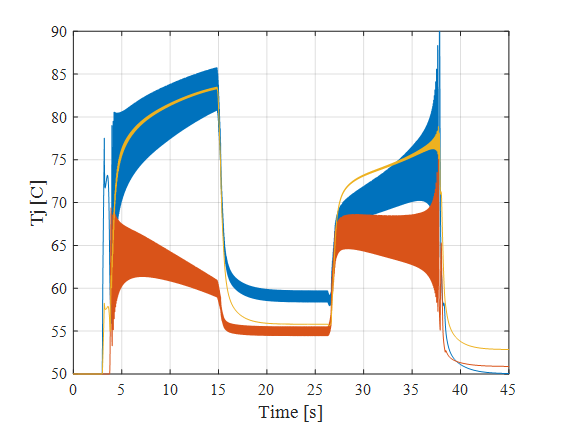
Projektdetails
- Typ
- Forschungsprojekt
- Forschungsfeld
- Elektrotechnik
- Themen
- Elektrotechnik und Messtechnik und Mobilität
- Hochschule/Institut
- Hochschule für Technik und Umwelt FHNW / Institut für Elektrische Energietechnik
- Partner
- ECPE GmbH
- Förderung
- ECPE - European Center for Power Electronics
- Laufzeit
- 2 Jahre
- Mitarbeit
- Dr. Paula Diaz Reigosa, Prof. Dr. Nicola Schulz, Michael Ramseier
Kontakt

Prof. Dr. Nicola Schulz
- Telefon
- +41 56 202 75 73 (Direkt)
- nicola.schulz@fhnw.ch